- Pendahuluan
Munculnya kesadaran terhadap ilmu dan teknologi nano di inspirasi dan di dorong oleh pemikiran futuristik dan juga penemuan peralatan pengujian dan bahan-bahan. Pada tanggal 29 Desember 1959 dalam pertemuan tahunan Masyarakat Fisika Amerika (American Physical Society) di Caltech, memunculkan suatu isu yaitu permasalahan memanipulasi dan mengontrol atom (dengan ukuran 0,001 nm) dan molekul (dengan ukuran 0,1 nm) pada dimensi kecil (nanometer). Mikoskop gaya atom dikembangkan oleh Gerd Binnig dan Heinrich Rohrer pada awal tahun 1980 di pusat penelitian IBM – Zurich.
Di tahun 1981, Scanning Tunneling Microscopy (STM) diciptakan oleh Heinrich Rohrer dan Gerd Binnig (Pemenang Hadiah Nobel Fisika tahun 1986). Beberapa tahun kemudian (1986), Gerg Binnig, Calfin F Quate, dan Christoph Gerber menemukan Atomic Force Microscope (AFM). Melalui peralatan STM dan AFM, para ilmuwan dapat melihat, memanipulasi, dan mengontrol atom-atom secara individu di dimensi nano. Walaupun pengembangan AFM sudah dilakukan pada tahun-tahun sebelumnya, pada tahun 1986 inilah implementasi eksperimental AFM dilakukan pertama kalinya.
AFM salah satu metoda karakterisasi dari keluarga SPM (Scanning Probe Microscopy) bekerja pada bagian permukaan bahan dengan melibatkan interaksi antara probe dan permukaan bahan melalui proses fisis tertentu. Interaksi ini kemudian dapat men-generate citra permukaan bahan pada skala mikroskopik, sehingga susunan partikel pada permukaan bahan dapat terlihat dengan jelas. Berbeda dengan microscopy lainnya, metoda karakterisasi ini hanya melibatkan gaya yang terjadi antara tip dan sampel. Gaya yang terjadi bisa berupa gaya tarikan atau dorongan. Setiap gaya akan mengakibatkan pembengkokan tertentu pada bagian cantilever dimana akan terdeteksi oleh berkas laser dan kemudian ditangkap oleh detektor yang kemudian akan dicitrakan menjadi sebuah image yang bernilai.
- Pengertian AFM
Mikroskop gaya atom (Atomic force microscope, AFM) adalah jenis mikroskopdengan resolusi tinggi yang mana resolusinya mencapai seperbilangan nanometer (1000 kali lebih kuat dari batas difraksi optik). Nano adalah satuan panjang sebesar sepertriliun meter (1 nm = 10-9 m). Bahan berstruktur nano merupakan bahan yang memiliki paling tidak salah satu dimensinya berukuran <100 nm. Atomic force microscope mampu menampilkan gambar dimana ukurannya lebih kecil dari 20 ms. Mikroskop ini juga memungkinkan menampilkan gambar dari kristal yang lunak dan permukaan polimer
Mikroskop gaya atom ini merupakan salah satu alat untuk penggambaran, pengukuran, dan manipulasi materi pada skala nano. Cara untuk mendapatkan informasi pada Mikroskop gaya atom dengan meraba permukaan dengan menggunakan sebuah alat pemeriksa mekanik yang disebut dengan piezoelektrik. Elemen piezoelektrik ini yang memfasilitasi perintah elektronik gerak dengan sangat akurat dan tepat sehingga membuatnya dapat memindai dengan presisi tinggi.
Mikroskop gaya atom terdiri dari sebuah penopang (cantilever) dengan ujung yang tajam sebagai alat pemeriksa (probe) yang digunakan untuk memindai permukaan sampel. Penopang tersebut biasanya terbuat dari silikon dengan radius kelengkungan ujung mencapai bilangan nanometer. Ketika ujungnya dibawa mendekati permukaan sampel, gaya antara ujung tajam pemindai dengan permukaan sampel menyebabkan pelengkungan penopang sesuai dengan hukum Hooke. Tergantung pada situasinya, gaya yang diukur AFM meliputi gaya kontak mekanik, gaya van der waals, gaya kapiler, ikatan kimia, gaya elektrostatik, gaya magnet, gaya casimir, gaya pelarutan, dan lain-lain.
- Resolusi (tingkat ketelitian) AFM
Atomic force microscope (AFM) merupakan suatu jenis mikroskop yang mampu memberikan informasi topografi tiga dimensi suatu permukaan pada skala hingga nanometer. Resolusi lateralnya mencapai 1,5 nm sedangkan resolusi vertikalnya mencapai 0,05 nm. Artinya ketelitian AFM dalam mengukur ketinggian suatu pemukaan lebih besar daripada ketelitiannya dalam mengukur panjang atau lebar.
- Kegunaan AFM
AFM merupakan alat yang di gunakan untuk memanipulasi ukuran atom atau molekul dan struktur pada berbagai permukaan agar dapat mempermudah kegiatan dari berbagai macam ilmu pengetahuan, misalnya dalam ilmu fisika, kimia, dan bidang biologi.
- Dalam ilmu Fisika, alat ini lebih mempermudah para ilmuwan dalam mengetahui struktur atom secara langsung, sehingga dapat di ubah dan di manipulasi untuk kepentingan ilmu sains.
- Dalam ilmu kimia, alat ini dapat menjelaskan bagaimana struktur dari berbagai macam molekul, sehingga lebih mudah dalam membuat suatu reaksi kimia.
- Dalam bidang biologi yaitu untuk menyelidiki struktur, fungsi dan spesifik sel. Misalnya untuk meyelidiki struktur dan fungsi hubungan antara bakteri Streptococcus mutans yang merupakan dasar aetiological pada gigi mati tulang manusia (gigi).
- Sampel AFM
AFM dapat digunakan untuk sampel yang bersifat konduktor maupun isolator seperti klaster atom dan molekul, makromolekul, dan spesies biologi seperti sel, DNA, dan protein. Untuk masalah sampel yang digunakan, persyaratannya hanya memiliki paling tidak salah satu dimensinya berukuran < 100 nm. Sampel tidak perlu di lapisi dengan karbon atau lapisan apapun yang dapat merusak sampel.
Untuk persiapan awal terhadap sampel adalah sebagai berikut :
- Letakkan sample pada tempat sample yang ada pada alat
- Pastikan ujung tip berada tepat di permukaan sample
- Hidupkan alat dan layar komputer
- Komponen-komponen AFM
Komponen-komponen penting yang ada pada mikroskop gaya atom diantaranya adalah :
- Probe
Merupakan alat pemeriksa yang secara langsung berinteraksi dengan permukaan sampel (Tip) dan cantilever dengan panjang 100 – 200 μm dengan lebar 10 – 40 nm, serta ketebalan 0.3 – 2.0 μm.
- Ujung jarum atau Tip
Tip merupakan ujung dari jarum pada ujung cantilever, tempat diamana terjadi kontak dengan sampel yang akan dicitrakan. Tip digunakan untuk memindai, meraba (scanning) sepanjang permukaan sampel/spesimen sehingga dapat mengkarakterisasi suatu bahan. Panjang Tip kurang dari 5 μm dan diameter ujung Tip biasanya kurang dari 10 nm. Ketelitian dari gambar yang dihasilkan sangat tergantung dari besar atau kecilnya tip ini. Material yang dipakai pada tip ini biasanya terbuat dari Silikon atau Silikon Nitrida (Si3N4). Material ini digunakan selain tahan lama juga menjadikan sampel menjadi anti air. Ujung dari tip ini biasanya sekitar 10 nm atau 100 atom.
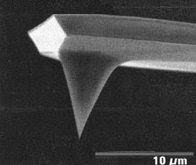
Gambar : Tip
3. Cantilever
Merupakan sebuah penopang dan merupakan tempat dimana tip menempel. Berfungsi sebagai tempat mendaratnya sinar laser. Bahan dari Cantilever ini pada umumnya sama dengan bahan pada pada tip, bentuknya biasanya ”V” pada ujungnya atau berbentuk datar saja “I”. Ukuran panjang dari suatu cantilever ini berkisar dari 100 – 500 μm, dan hanya memiliki beberapa mikron untuk tebalnya. Keadaan ini menjadikan cantilever ini fleksibel tetapi masih kuat untuk menahan, tip pada ujungnya.
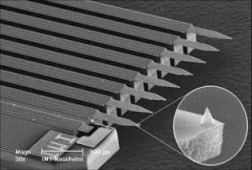
Gambar : Cantilever
4. Scaner piezoelectric
Scanner ini berfungsi untuk mengontrol pergerakan tip atau sampel pada arah x, y dan z. Pada scanner terdapat piezoelectric material yang mampu memberikan pergerakan dalam skala nanometer. Piezoelektrik dapat mengubah tekanan menjadi suatu tegangan listrik untuk diolah pada komputer atau sebaliknya mengubah tegangan menjadi suatu tekanan.
5. Laser
Devais elektronik yang berfungsi untuk menembakkan laser ke arah cantilever.
6. Detektor
Merupakan pendeteksi laser pantulan.
7. Photodioda
8. Perangkat komputer
Digunakan sebagai pengolah data.
7. Bentuk Fisis AFM

Skema AFM Secara Keseluruhan

Gambar : Probe, Head of AFM
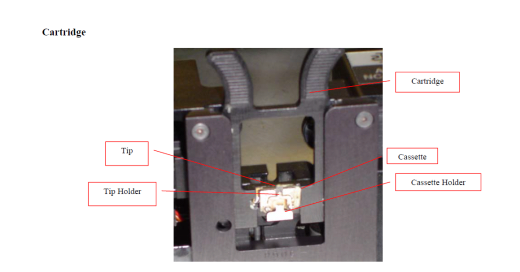
Gambar : Cartridge of AFM
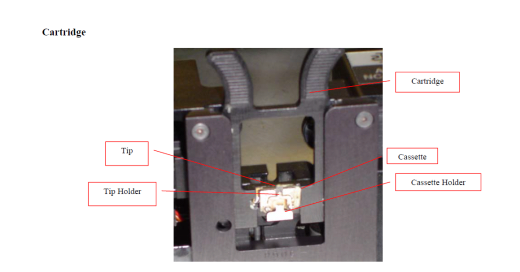
8. Prinsip Kerja AFM
Secara sederhana, prinsip kerja dari AFM yaitu saat posisi Tip dipermukaan sampel, maka dapat di deteksi oleh laser dan dipantulkan ke photodioda untuk diteruskan ke detektor. Kemudian, dari detektor langsung ke komputer/monitor untuk mendapatkan penggambaran dalam skala nano atom. Secara teknis prinsip kerja AFM ditunjukkan pada Gambar di bawah :
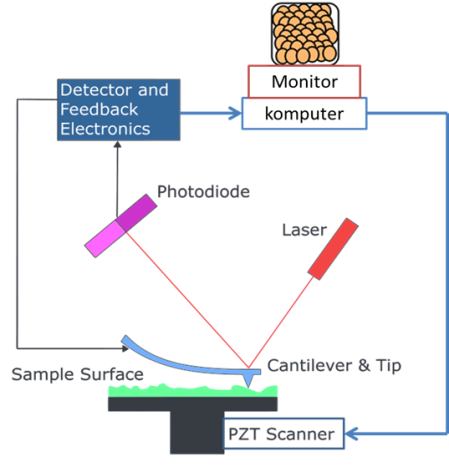
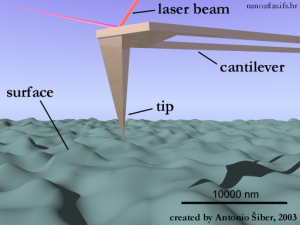
Pada posisi normal, sinar laser diarahkan pada ujung cantilever. Oleh cantilever, laser ini dipantulkan menuju bagian tengah detektor photodioda. Ketika tip mendekati permukaan sampel, terjadi gaya tarik atau gaya tolak antara tip dan permukaan sampel. Gaya ini akan menyebabkan cantilever bengkok. Bengkoknya cantilever ini akan terdeteksi dengan adanya pergeseran posisi laser yang ditangkap oleh photodioda. Semakin besar gaya tarik/tolak antara tip dan permukaan sampel, pergeseran laser akan semakin besar. Karena besarnya gaya tarik/tolak tergantung pada jarak antara tip dan permukaan sampel, maka topografi permukaan sampel dapat diketahui dengan melakukan scanning tip sepanjang permukaan sampel.
AFM bekerja dengan cara memanfaatkan gaya tarik-menarik dan tolak-menolak yang bekerja antara cantilever dan permukaan sampel pada jarak beberapa nanometer. Persamaan gaya ini dinyatakan dalam persamaan potensial Lennard-Jones. Gaya tarik menarik terjadi saat cantilever dan sampel saling menjauh. Sementara itu, gaya tolak-menolak terjadi saat cantilever dan sampel saling mendekat.
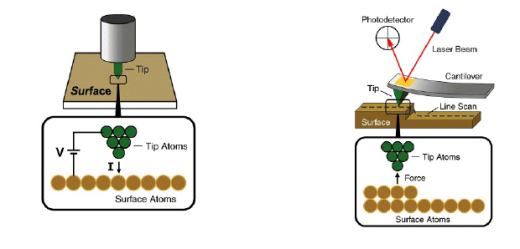
Pada AFM, cantilever bekerja meraba-raba (melakukan scanning) permukaan sambil menjaga jarak antara cantilever dengan permukaan sampel tetap sama beberapa nanometer. Gaya tarik-menarik dan tolak-menolak yang terjadi di antaranya menyebabkan perubahan posisi cantilever. Perubahan posisi cantilever selama meraba-raba permukaan sampel ditangkap dengan laser dan menyebabkan perubahan pantulan laser pada sensor photodioda. Perubahan posisi tangkapan laser pada photodioda ini diolah dengan rangkaian elektronik dan komputer untuk kemudian diwujudkan dalam bentuk data gambar 3D pada layar monitor.
Selama proses perabaan (scanning), pengaturan jarak antara cantilever dan permukaan sampel serta pergerakan sampel diatur secara simultan dan sinergis melalui komunikasi antara rangkaian elektronik (komputer) dengan cantilever dan material piezoelektrik. Proses perubahan tekanan menjadi tegangan atau tegangan menjadi tekanan ini diatur oleh piezoelektrik. Untuk menampilkannya dalam komputer sinyal tegangan ini diubah ke sinyal analog. Karena sangat kecil maka diperkuat dengan amplifier. Kemudian sinyal dikonversi ke digital sehingga data dapat diolah oleh komputer.
Dengan memanfaatkan gaya tersebut, berbagai macam sampel dapat diamati, tidak terbatas hanya pada benda yang bisa menghantarkan listrik saja. AFM juga bisa bekerja pada suhu ruangan dan tekanan udara biasa. Hal ini menyebabkan sampel organik pun bisa diamati dengan AFM. Untuk meningkatkan kemampuan AFM, diperlukan diameter ujung tip yang sangat kecil dan juga frekuensi resonansi cantilever yang tinggi agar sensitivitas terhadap perubahan posisi cantilever meningkat dan AFM bisa bekerja dengan lebih cepat.
Untuk cara kerja alat Atomic force microscopy ini adalah:
- Selama scan, tip (jarum) dari cantilever (sensor) maju mundur sepanjang permukaan sampel.
- Gerak scan arah x,y, dan z dikontrol oleh tube scanner piezoelektrik.
- Untuk mendeteksi setiap defleksi dari jarum, digunakan laser yang dipantulkan ke ujung tip, selanjutnya malalui cermin laser menuju photodioda.
- Piezoscanner dan photodioda terhubung melalui loop feedback, yaitu komponen yang berfungsi untuk menterjemahkan signal yang diberikan oleh tip pada photodioda detektor. Signal yang diterima akan diterjemahkan untuk menggerakkan piezoelectric material, kemudian hasilnya di tampilkan pada layar komputer yang telah tersedia.
Input dan Output alat Aomic Force Microscope (AFM)
- Inputnya adalah atom atau molekul yang berukuran < 100 nm.
- Outputnya adalah berupa gambar dari suatu atom/molekul, dimana gambar yang dihasilkan adalah gambar tiga dimensi sehingga gambar yang dihasilkan sangat jelas, baik bentuk maupun struktur penyusun atom.

Gambar : hasil non-contact modedari butir titanium-nitrida, a) scanner 10μm b) 5 μm
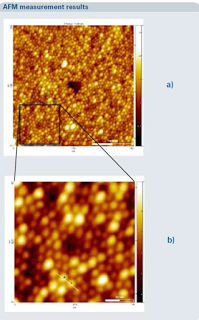 a. 300 nm x 300 nm topografi scan sampel partikel FeO.
a. 300 nm x 300 nm topografi scan sampel partikel FeO.
b. Zoom ke dalam, scan ukuran 85 nm x 85 nm. Garis putih dengan panah menunjukkan posisi dari sebuah profil garis.
Mikroskop gaya atom memiliki beberapa sifat fisis, diantaranya yaitu:
- Perbesaran
Dimensi dan Perbesaran unit umum dari dimensi yang digunakan untuk membuat pengukuran dalam mikroskop atom adalah nanometer. Pembesaran di mikroskop atom adalah rasio ukuran sebenarnya fitur untuk ukuran fitur bila dilihat di layar komputer.
- Keramik Piezoelektrik Transducer
Bahan piezoelektrik mengalami perubahan geometri ketika ditaruh dalam medan listrik.
- Gaya Sensor
Mikroskop gaya atom membutuhkan kekuatan sensor untuk mengukur kekuatan antara probe kecil dan permukaan yang dicitrakan. Jenis umum dari sensor gaya menggunakan hubungan antara gerak penopang dan gaya diterapkan.
- Kontrol Umpan Balik
Kontrol umpan balik digunakan umumnya untuk menjaga gerak suatu objek dalam suatu hubungan tetap ke objek lain.
- Resolusi pada Mikroskop Gaya Atom
- Resolusi plane tergantung pada geometri probe yang digunakan untuk memindai. Secara umum, semakin tajam probe maka semakin tinggi resolusi gambar pada mikroskop gaya atom.
- Resolusi Vertikal dalam Mikroskop gaya atom dibentuk oleh getaran relatif probe di atas permukaan.
- Interaksi Permukaan Probe
Interaksi permukaan probe dan permukaan mekanis, merupakan kekuatan yang terjadi ketika atom-atom pada probe fisik berinteraksi dengan atom di permukaan.
- Kontaminasi Permukaan
Kontaminasi ini dapat terdiri dari air dan hidrokarbon dan tergantung pada lingkungan mikroskop. Ketika probe Mikroskop gaya atom datang ke dalam kontak dengan kontaminasi permukaan, gaya kapiler dapat menarik probe ke arah permukaan.
9. Metode Kerja AFM
Metode kerja AFM sendiri ada beberapa macam di antaranya adalah :
- Metode Sentuh
Pada metode sentuh, cantilever disentuhkan ke dalam permukaan sampel. Sambil scanning dilakukan, perubahan posisi cantilever akibat gaya tolak menolak antara cantilever dan permukaan sampel diolah dan diwujudkan dalam data gambar 3 dimensi permukaan sampel.


Skema dari metode sentuh dan gambar dari oligomer cholera
Pada metode sentuh, tip cantilever berada sangat dekat dengan permukaan sampel sehingga terjadi gaya tolakan. Gaya tolakan ini menyebabkan cantilever menekuk. Konstanta pegas dari cantilever ini lebih kecil daripada konstanta pegas antar atom sehingga saat terjadi gaya tolak, cantilever inilah yang akan menekuk tanpa menyebabkan kerusakan pada sampel. Saat tip menelusuri permukaan sampel, perbedaan tinggi rendahnya sampel menyebabkan perbedaan gaya tolakan. Agar gaya tolakan selalu konstan, feedback control mengirim signal ke piezo-electric material untuk bergerak ke atas atau ke bawah. Pergerakan ini direkam dan diterjemahkan sebagai topografi 3D permukaan sampel. Jenis tip yang digunakan pada AFM mode sentuh biasanya terbuat dari silikon nitrida karena mempunyai fleksibilitas yang baik. Biasanya pihak perusahan menjual tip dengan berbagai ukuran dan tipe coatingnya sehingga pengguna dapat menyesuaikannya dengan sampel yang akan dianalisa.
Keuntungan metode sentuh :
- Scanning kecepatan tinggi dan Resolusi skala atomik.
- Sangat bagus pada bahan kasar dengan tingkat perubahan yang besar pada topography vertical.
Kerugian metode sentuh :
- Gaya lateral yang berlebihan dapat menggores sampel dan merusak tip.
- Resolusi yang dihasilkan kurang baik terutama pada sampel yang soft (lunak).
- Mudah terjadi kontaminasi pada tip akibat kontak dengan material yang mudah lepas di permukaan sampel.
- Metode Tak sentuh
Pada metode tak sentuh, gaya yang bekerja antara cantilever dan permukaan benda diatur agar tidak berubah. Pada awalnya cantilever digetarkan pada frekuensi resonansinya. Sambil scanning dilakukan, perubahan tekstur atau jarak antara cantilever dan permukaan benda menyebabkan terjadinya gaya antara keduanya yang merubah frekuensi resonansinya. Gaya tarik menyebabkan frekuensi resonansi turun. Gaya tolak menyebabkan frekuensi resonansi naik. Pada metode tak sentuh ini juga berlaku hukum Hooke pada cantilever.


Skema metode tak sentuh dan gambar polimer raspberry
Pada metode tak sentuh, jarak antara tip dengan sampel lebih besar sehingga gaya yang dirasakan adalah gaya tarikan. Mode ini relatif sulit dilakukan pada kondisi ambien karena adanya lapisan air yang teradsorpsi pada permukaan tip ataupun permukaan sampel. Saat tip mendekati permukaan sampel, lapisan air menyebabkan gaya kapiler terjadi secara tiba-tiba sehingga tip langsung kontak dengan permukaan sampel.
Keuntungan metode tak sentuh :
- Baik digunakan pada sampel yang permukaannya lunak.
- Gaya lemah diberikan pada permukaan sampel tanpa merusak permukaan sampel.
Kerugian metode tak sentuh :
- Resolusi lateral yang rendah diakibatkan separasi tip-sampel.
- Biasanya digunakan pada sampel hidropobik.
- Sangat sensitif terhadap vibrasi eksternal.
- Metode Tapping
Pada metode tapping, cantilever digetarkan (berisolasi) pada frekuensi resonansinya. Probe melakukan proses “tap” pada permukaan sampel ketika proses scanning berjalan. Saat scanning dilakukan, perbedaan topografi sampel menyebabkan pergeseran frekuensi resonansinya. Pergeseran frekuensi ini yang kemudian diterjemahkan menjadi topografi permukaan melalui serangkaian proses yang dilakukan oleh feedback control. Sama seperti metode sentuh, metode tapping berada pada daerah gaya tolakan antara sampel dan tip. Jenis tip yang digunakan biasanya terbuat dari kristal silikon. Jenis tip ini dapat bergetar pada frekuensi tinggi namun lebih rapuh daripada tip dari silikon nitrida.
Keuntungan metode tapping :
- Resolusi lateral yang tinggi (1 nm – 5 nm).
- Sangat baik untuk sampel yang lunak seperti spesimen biologi, dan juga untuk sampel yang mempunyai adhesi permukaan rendah seperti DNA dan karbon nanotubes.
- Gaya yang lemah serta kerusakan yang minim pada sampel.
- Hampir tidak ada gaya lateral.
Kerugian metode tapping :
- Kecepatan scan yang lebih lambat daripada metode sentuh.
Contoh gambar metode tapping dari sampel biologi, nucleosomal DNA
10. Kelebihan dan Kelemahan AFM
Mikroskop gaya atom (AFM) memiliki beberapa kelebihan dan kelemahan jika dibandingkan dengan mikroskop elektron.
Kelebihan Mikroskop gaya atom
- AFM mampu menampilkan gambaran permukaan sampel secara tiga dimensi sehingga kita bisa mengetahui ukuran nano partikel secara lebih mendetail.
- Mikroskop gaya atom mampu menampilkan gambar dengan ukuran lebih kecil dari 20 nm dan menampilkan gambar dari kristal yang lunak dan permukaan polimer.
- AFM digunakan baik untuk bahan konduktor, isolator, semikonduktor dan insulator.
- Sampel yang akan dilihat menggunakan mikroskop gaya atom tidak memerlukan perawatan khusus seperti melapisi dengan karbon dan lain-lain yang dapat menimbulkan perubahan ireversibel ataupun kerusakan pada sampel. AFM dapat bekerja sebaik mungkin dalam kondisi lingkungan seperti apapun.
- AFM tidak membutuhkan kondisi hampa udara (vakum). Karena itu, AFM sangat baik digunakan untuk deteksi sel dan sampel biologi lainnya tanpa membuat sel biologi tersebut menjadi kering.
- Mikroskop gaya atom dapat bekerja dengan baik pada suhu ruangan dan tekanan udara biasa atau bahkan pada lingkungan cair. Hal ini menyebabkan mikroskop gaya atom memungkinkan untuk mempelajari biologi makromolekul, mengamati kehidupan suatu organism dan makhluk hidup.
- Secara prinsip, mikroskop gaya atom menyediakan resolusi yang lebih tinggi dibanding dengan mikroskop elektron. Hal tersebut telah dibuktikan bahwa mikroskop gaya atom dapat memberikan resolusi atom lebih tinggi pada Ultra High Vacum (UHV) dan dalam lingkungan cair. Resolusi mikroskop gaya atom yang tinggi ini sebanding dengan resolusi untuk mikroskop pemindai terowongan dan mikroskop elektron transmisi.
Kelemahan Mikroskop gaya atom
Dilihat dari scan ukuran gambar. Dalam satu kali scan, mikroskop elektron mendapatkan gambar area dalam unit mm dengan kedalaman mm. Sedangkan pada mikroskop gaya atom, hanya dapat menangkap gambar dengan ketinggian maksimum 10-20 mikrometer dan luas maksimum pengamatan 150 x 150 mikrometer. Artinya, AFM hanya mampu menampilkan gambar yang ukurannya sangat kecil, sehingga jika ukurannya cukup besar, AFM tidak dapat menampilkan gambar. Memiliki pemindaian yang terbatas. Secara tradisional, mikroskop gaya atom tidak dapat memindai gambar secepat mikroskop elektron. Mikroskop gaya atom memerlukan waktu lebih lama untuk memindai, sedangkan mikroskop elektron mampu memindai dengan cepat meskipun dengan hasil pemindaiannya memiliki kualitas yang relatif rendah. Lambatnya proses scanning selama pemindaian oleh mikroskop gaya elektron sering menyebabkan penyimpangan panas pada gambar sehingga membuat mikroskop gaya atom kurang cocok untuk pengukuran akurat jarak antara fitur topografi pada gambar. Namun, beberapa desain memberikan saran untuk meningkatkan produktivitas mikroskop pemindaian dengan menggunakan video Mikroskop gaya atom. Untuk menghilangkan distorsi pada gambar yang disebabkan oleh penyimpangan panas, beberapa metode telah diperkenalkan.
Gambar Mikroskop gaya atom juga dapat dipengaruhi oleh histeresis dari bahan piezoelektrik dan cros-talk antara x,y,z sumbu yang mungkin memerlukan perangkat tambahan berupa pernagkat lunak dan penyaringan. Penyaringan ini bisa digunakan untuk meratakan fitur topografi yang keluar. Namun, mikroskop gaya atom baru memanfaatkan scanner loop tertutup yang praktis untuk menghilangkan masalah ini. Beberapa scanner terpisah ortogonal juga berfungsi untuk menghilangkan masalah cros-talk. Seperti halnya teknik pemindaian lain, ada kemungkinan gambar yang dihasilkan dari pemindaian tip tidak cocok. Gambar ini tidak dapat dihindari, namun kejadaian dan efeknya pada hasil dapat dikurangi melalui berbagai metode.
Berdasarkan sifat dari probe Mikroskop gaya atom, biasanya tidak dapat untuk mengukur dinding yang curam atau overhang. Maka, dibuat cantilever khusus sehingga Mikroskop gaya atom dapat digunakan untuk memodulasi probe ke samping serta atas dan bawah (seperti pada metode sentuh dan tak sentuh) untuk mengukur dinding samping.
11. Aplikasi AFM
Beberapa aplikasi pada Mikroskop gaya atom (AFM) diantaranya adalah :
- Sebagai pencitraan penggambaran dari struktur permukaan dalam bentuk padat
- Analisa kekerasan substrat
- Step formation pada deposisi epitaxial film tipis
- Analisa ukuran grain (grain size)
- Melalui proses AFM In Situ dengan perubahan temperatur, kita dapat mempelajari perubahan struktur
REFERENSI
- tips/documents/atomic-force-microscopy-55a359a13c179.html
- https://stunecity.wordpress.com/2011/02/04/berkenalan-dengan-spm-scanning-probe-microscope-afm-atomic-force-microscope/
- https://id.wikipedia.org/wiki/Mikroskop_gaya_atom
- http://majalah1000guru.net/2011/02/melihat-benda-nanometer/
- http://lizaaufklarung.blogspot.co.id/2011/01/atomic-force-microscopy-afm.html
- http://wawasanedukasi.blogspot.co.id/2015/05/mikroskop-gaya-atom-afm.html
- https://roilbilad.wordpress.com/2010/11/09/atomic-force-microscopy-afm/
- http://material-sciences.blogspot.co.id/2015/04/mikroskop-gaya-atom-atomic-force.html

No comments:
Post a Comment